苏州鸿博信息技术有限公司
地址:苏州市澄湖西路500号金鑫商务大厦1306-1310室
电话:0512-65183786
传真:0512-66356557
邮箱:info@hongbosoft.com.cn
网址:www.hongbosoft.com.cn
Moldex3D芯片封装解决方案
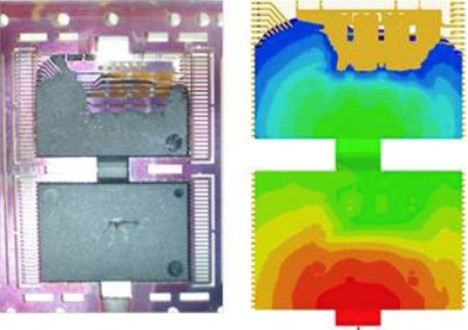
IC封装是以环氧树脂材料 (Epoxy Molding Compound, EMC)进行封装的制程,藉以达到保护精密电子芯片避免物理损坏或腐蚀。在封装的过程中包含了微芯片和其他电子组件(所谓的打线)、热固性材料的固化反应、封装制程条件控制之间的交互作用。由于微芯片封装包含许多复杂组件,例如 : 环氧树脂(EMC)、硅芯片、导线架及高密度金线,故芯片封装制程中将会产生许多制程挑战与不确定性。常见的IC封装问题如:充填不完全、空孔、金线偏移、导线架偏移及翘曲变形等。
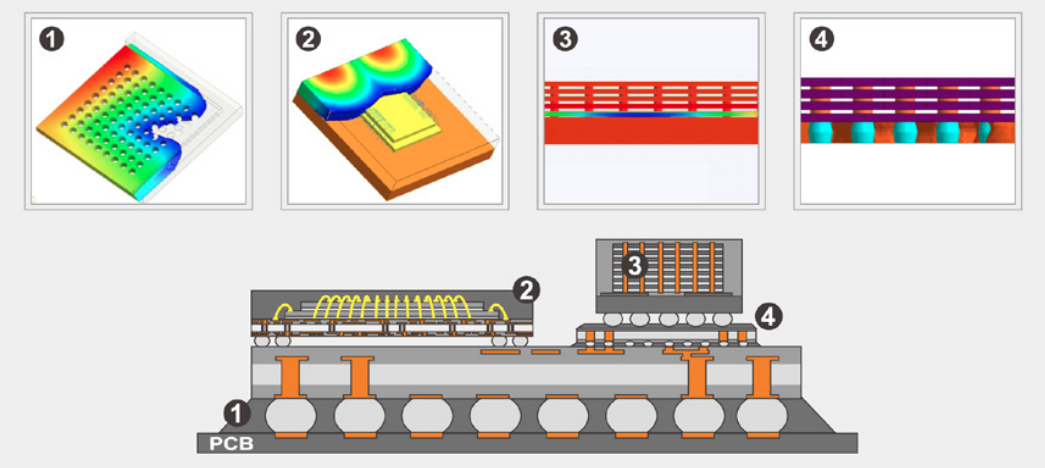
Moldex3D 芯片封装模块提供完整系列的解决方案,包含 : 转注成型、毛细底部填胶(CUF)、压缩成型、崁入式晶圆级封装(EWLP)、非流动性底部填胶(NUF)/非导电胶制程(NCP)。针对网格生成,使用者可以选用自动化网格简单的项目设定;另外,针对更复杂封装组合,还可以采用手动产生网格的方式(例如: 导线架与硅芯片堆栈)完成项目设定。
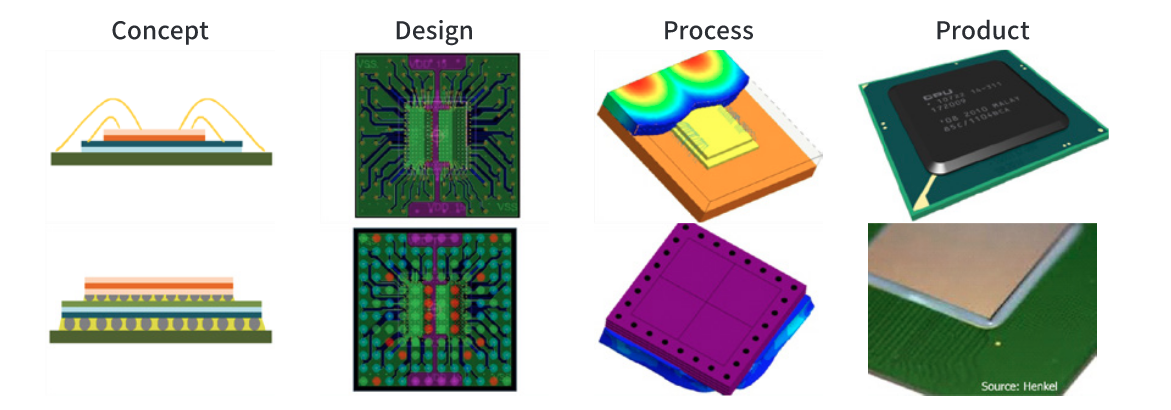
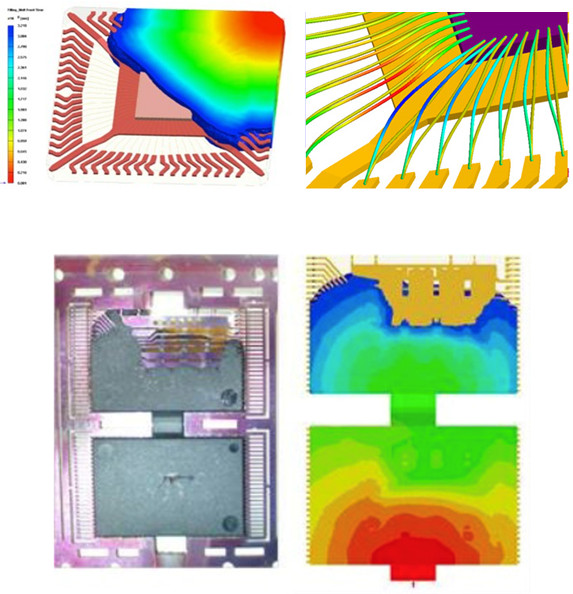
产品组合
● 产品内含模组功能 ○ 产品可加购模组功能
标准分析模组
成型製程
轉注成型
网格建构技术
Mesh
●
Designer
●
Cadence接口功能
○
仿真功能
●
热传分析
●
●
●
●
●
计算能力
Project
●
8
材料特性测试
黏性度 (Rheometer)
●
固化反应动力学 (DSC)
●
进阶模组分析
成型制程
压缩成型
底部填胶
后熟化
制程解決方案
压缩成型
毛细底部填胶(CUF)
材料化学收缩
材料特性测试
比容 (PVTC)
●
○
●
黏弹性模量(DMA)
○
○
●
接触角
○
●
非流动性底部填胶(NUF)
嵌入式晶圆级封装(EWLP)
成型底部填胶(MUF)
黏弹应力释放
|
平台 |
作业系统 |
|
Windows / x86-64 |
Windows 10 family |
|
Windows 8 family |
|
|
Windows 7 family |
|
|
Windows Server 2008 |
|
|
Windows HTC Server 2008 |
|
|
Windows Server 2012 |
|
至少规格 |
|
|
CPU |
Intel® Core i7 processor |
|
记忆体 |
16 GB 记忆体及至少1 TB的闲置空间 |
|
建议规格 |
|
|
CPU |
Intel® Xeon® E5 processor* |
|
记忆体 |
32 GB 记忆体及至少 2 TB的闲置空间 |
地址:苏州市澄湖西路500号金鑫商务大厦1306-1314室
电话:0512-65183786 传真:0512-66356557
质量保证:提供可靠的优质产品,帮助客户快速,精确的处理问题
价格合理:高效内部成本控制,减少了开支,让利与客户!
技术支持:拥有资深的技术支持团队,确保客户问题得到快速解决!
版权所有 Copyright © 苏州鸿博信息技术有限公司 All Right Reserved 备案号:苏ICP备16063524号-1